Cette large gamme de spectromètres de masse est dédiée à l’analyse de gaz résiduels (RGA), de plasma, mais aussi à l’analyse de surface et à la détection de fin d’attaque par SIMS.
HPR-30 Series : système d'analyse des gaz résiduels pour l'analyse des procédés sous vide
- Systèmes d’échantillonnage de processus sous vide configurables et polyvalents
- Options de gamme de masse 200, 300, 500 ou 1000 amu
- Détection des fuites
- Analyse des tendances du processus
- Surveillance de la contamination

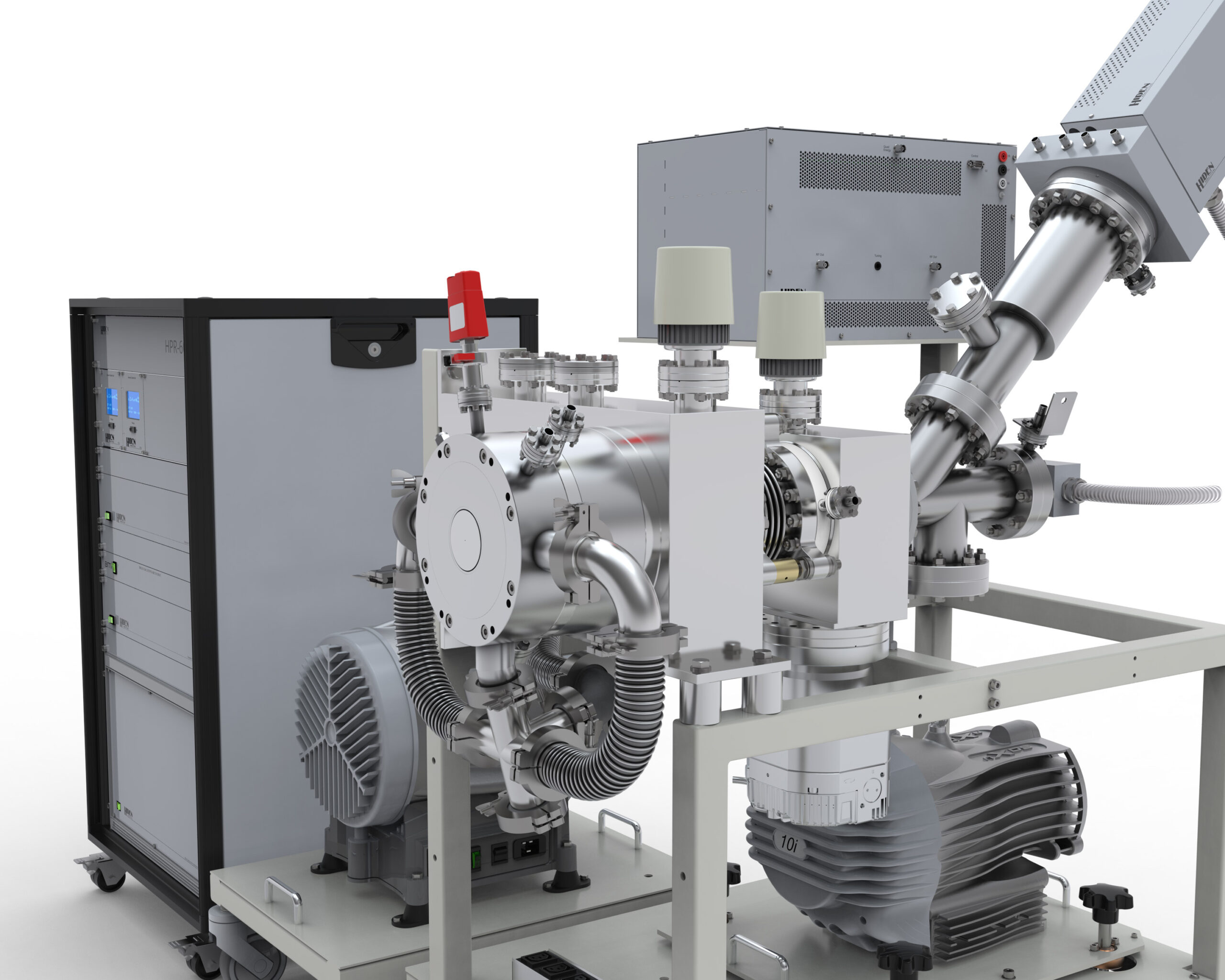
HPR-60 MBMS : système d'analyse des neutres, des radicaux et des ions
- Échantillonnage par faisceau moléculaire à la pression atmosphérique
- Analyse des ions +ve et -ve
- Cônes d’écumage remplaçables par l’utilisateur
- Mode d’ionisation par attachement d’électrons pour l’étude des radicaux électro-négatifs
- Mode d’ionisation douce APSI-MS pour l’analyse des radicaux
- Options de gamme de masse : 300, 510 ou 1000 amu
- Options de gamme d’énergie : 100 eV ou 1000 eV
HMT : système RGA bimode pour le diagnostic du vide et la surveillance des processus
- Mode HMT pour un fonctionnement à haute pression jusqu’à 5×10-3 mbar (pression partielle détectable min. 5×10-8 mbar)
- Mode RGA pour un fonctionnement à haute sensibilité à P < 10-4 mbar (pression partielle détectable min 2 x 10-11 mbar)
- Gamme de masse de 100 amu, interface de contrôle à distance (PC) via le logiciel MASsoft Professional PC
- Stabilité (moins de ±1% de variation de hauteur sur 24 h)
- Contrôle par le logiciel MASsoft via RS232, USB ou plusieurs systèmes via Ethernet LAN
- Accès rapide, balayage en mode mixte Trend et Analogique dans plusieurs fenêtres par exemple
- Affichage simultané en temps réel des données d’analyse de tendance sous forme graphique et tabulaire
- Curseur pour l’identification de la hauteur des pics sous le contrôle de la souris
- Soustraction du bruit de fond en temps réel, alignement automatique de l’échelle de masse
- Facilité d’exportation des données au format ASCII et vers tous les périphériques Windows
- Fonction d’échange dynamique de données pour le transfert de données en temps réel vers d’autres applications Windows™ compatibles avec le client DDE, par exemple Excel, le logiciel de contrôle statistique de processus SPC-IV


EQP Series : systèmes pour la recherche sur les plasmas
- Optique d’extraction d’ions contrôlée par logiciel pour une perturbation minimale du plasma
- Analyseur de secteur électrostatique à 45°, balayage de l’énergie par incréments de 0,05 eV/ 0,25 eV FWHM
- Perturbation minimale de la trajectoire des ions et transmission constante des ions à toutes les énergies
- Quadrupôle à triple filtre à pompage différentiel, options de gamme de masse jusqu’à 5000 amu
- Détecteur de comptage d’ions à impulsions de haute sensibilité et stabilité avec une gamme dynamique de 7 décades
- Ioniseur intégré accordable pour le potentiel d’apparition MS avec option de fixation des électrons
- Jauge de pénétrabilité et verrouillage pour assurer une protection contre les surpressions
- Option de déclenchement de signal et de déclenchement de signal programmable pour les études résolues en temps dans le plasma pulsé
- Option 1000eV, option flottante jusqu’à 10keV, coupe de Faraday pour les plasmas à haute densité
- Options de blindage Mu-Metal, Radio-metal, option de fonctionnement sous haute pression
- Commande MASsoft via RS232, RS485 ou Ethernet LAN
PSM : analyseur de masse et d'énergie pour le diagnostic des plasmas
- Collecteur à pompage différentiel avec bride de montage sur la chambre de traitement
- Quadrupôle à triple filtre à haute sensibilité/stabilité, options de gamme de masse jusqu’à 510 amu
- Détecteur de comptage d’ions à impulsions avec une plage dynamique de 7 décades
- Option d’analyse énergétique par balayage de polarisation polaire 100eV
- Optique d’extraction/exclusion d’ions avec ioniseur intégré accordable pour le potentiel d’apparition MS
- Jauge de pénétrabilité et verrouillage pour assurer une protection contre les surpressions
- Option de déclenchement de signal et de déclenchement de signal programmable pour les études résolues dans le temps dans un plasma pulsé
- Analyse des neutres et des radicaux en standard, analyse des ions +ve / -ve en option
- Options de blindage mu-métallique et radio-métallique, options de fonctionnement sous haute pression
- Commande MASsoft via RS232, RS485 ou Ethernet LAN


ESPion : sonde de Langmuir avancée pour le diagnostic des plasmas
- Taux d’acquisition de 15 scans par seconde avec interface D-O-E pour des analyses automatiques, semi ou manuelles
- Hiden, pionnier de la compensation RF passive
- ESPion possède l’impédance de blocage la plus élevée de toutes les unités disponibles sur le marché
- 4,25MOhm à 13,56 MHz cf. 100kOhm
- Chaîne multi-inductrice refroidie par gaz pour le fonctionnement du plasma à haute température
- La chaîne multi-inductrice refroidie par gaz est remplaçable par l’utilisateur pour s’accorder sur d’autres fréquences
- La sonde de référence compense les effets de basse fréquence
par exemple, le décalage du potentiel du plasma (par exemple, les parois anodisées de la chambre) ou le bruit (par exemple, l’alimentation électrique) - ESPion : les spécifications de plasma pulsé les plus rapides de toutes les sondes
- ESPionSoft contient tous les circuits de déclenchement nécessaires en standard
- Options d’entraînement linéaire automatique de 300, 600 ou 915 mm
- Vanne d’isolement verrouillée, sondes à 90°, commandes linéaires et rotatives combinées disponibles en option
- Cycle d’auto-nettoyage pour limiter la contamination de l’extrémité de la sonde
- Contrôle ESPionSoft via RS232, RS485 ou Ethernet LAN
XBS : système pour la surveillance de sources multiples dans les applications de dépôt MBE
- Haute sensibilité, détection améliorée de 100% à 5ppb, gamme de masse jusqu’à 510 amu
- Stabilité à long terme améliorée (moins de ±0,5% de variation de hauteur sur 24 h)
- Source d’ions transversale, acceptation du faisceau sur +/- 35° par rapport à l’axe transversal
- Contrôle de la source d’ions pour l’ionisation douce et la spectrométrie de masse à potentiel d’apparition
- Sensibilité améliorée pour une transmission de masse élevée, alignement automatique de l’échelle de masse
- Ouverture d’acceptation du faisceau de 2 mm – configurée en fonction de l’application spécifique de l’utilisateur
- Résistance améliorée à la contamination grâce à l’étage de pré-filtrage exclusivement RF
- Enveloppe intégrée, compatible UHV, refroidie à l’eau
- Limites de détection jusqu’à 30 ions/seconde dans les études par faisceau moléculaire
- Contrôle des taux de croissance de 1Å/minute et moins
- Contrôle MASsoft basé sur Windows™ via RS232, USB ou Ethernet LAN


IMP-EPD : système pour le contrôle de la gravure ionique et la qualité optimale du processus
- SIMS / MS haute sensibilité avec détecteur à comptage d’ions pulsé
- Quadrupôle à triple filtre, gamme de masse de 300 amu en standard
- Collecteur à pompage différentiel avec bride de montage sur la chambre de traitement
- Optique ionique avec analyseur d’énergie et ioniseur intégré
- Jauge de pénétration et verrouillage pour assurer une protection contre les surpressions
- Système de données avec intégration à l’outil de traitement
- Stabilité (moins de ±0,5% de variation de hauteur sur 24 h)
- Contrôle MASsoft via RS232, RS485 ou Ethernet LAN
- Communication programmable DDE, Digital I / O parallèle, RS232 Scripting
TPD Workstation : système pour les études de désorption programmée en température UHV (TPD/TDS)
- Spectromètre de masse Hiden 3F PIC pour une acquisition rapide des données (>500 points de données par seconde)
- Chambre UHV multiport pour la fixation d’instruments supplémentaires (par ex. Ellipsométrie)
- Mécanisme linéaire de transfert d’échantillons et sas de chargement, y compris vanne d’arrêt et hublot de visualisation
- Étage d’échantillon chauffé à 1000 °C
- Entraînement en Z pour un positionnement optimal de l’échantillon/du détecteur
- Veste de cuisson (200 °C max)
- Logiciel intégré de contrôle des protocoles expérimentaux
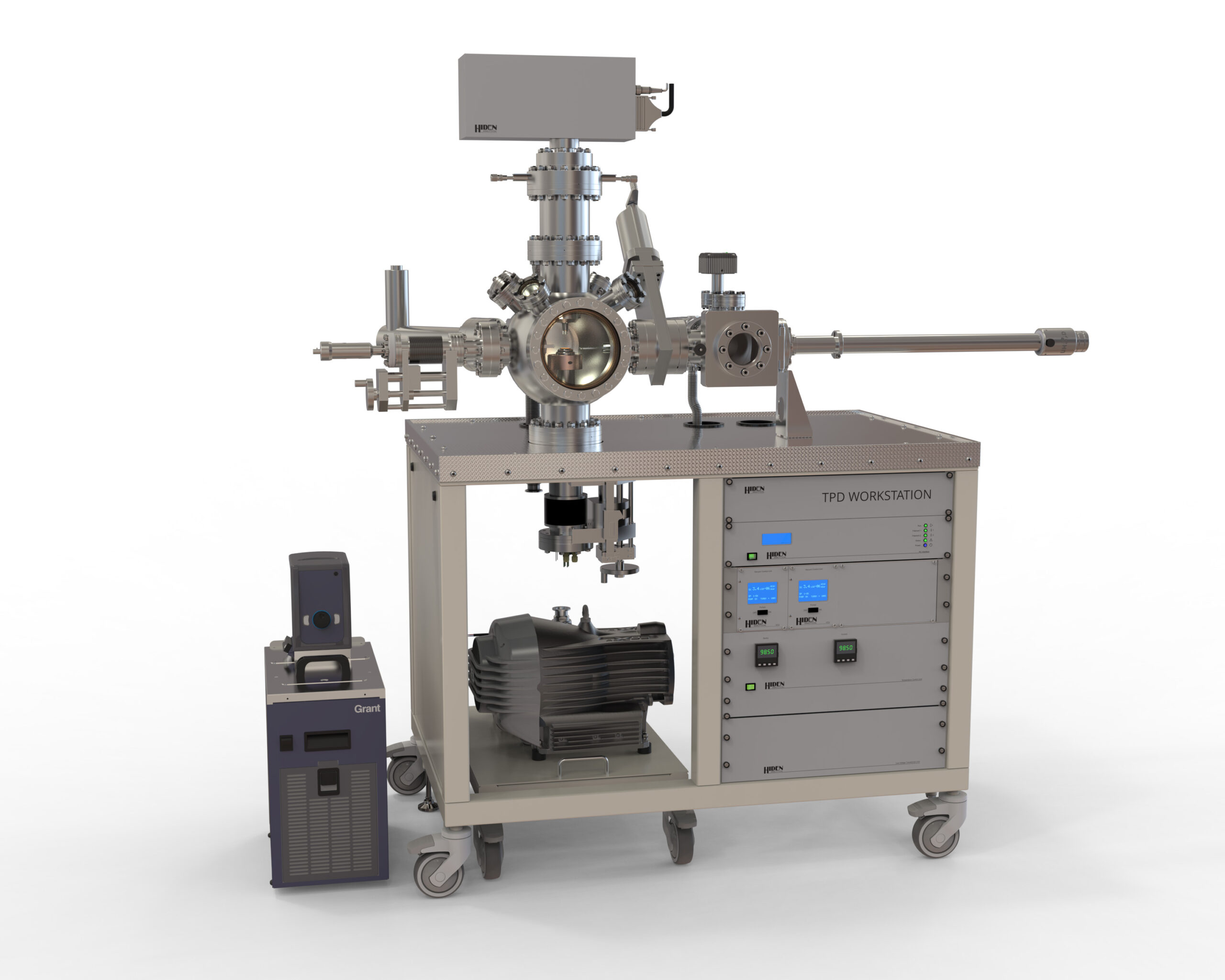
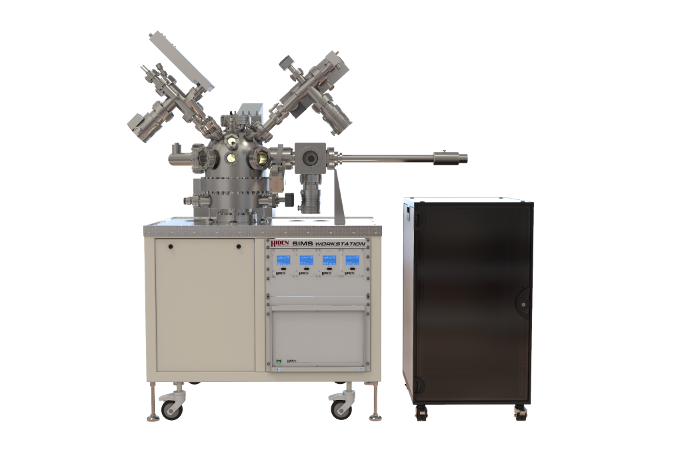
SIMS/SNMS Workstation : système d'analyse de surface UHV pour le profilage en profondeur de couches minces
- Analyseur SIMS MAXIM Hiden fonctionnant sous MASsoft Professional pour l’analyse des ppb
- Ioniseur intégré pour une analyse SNMS efficace
- Choix de sources d’excitation primaire à pompage différentiel
- Canons à gaz IG20, à césium IG5C, à gallium liquide haute performance ou IFG200 FAB
- Contrôle intégré de la trame du canon à ions avec déclenchement du signal pour le profilage en profondeur
- Canon à électrons en option pour la neutralisation des charges dans les études sur les isolants
- Chauffage d’étuvage de la chambre à vide
- Transfert rapide de l’échantillon, porte-échantillon et manipulateur avec verrouillage de charge
- Manipulateur UHV pour un positionnement optimal de l’échantillon
- Option d’imagerie élémentaire SIMS avec le programme d’imagerie SIMS LabVIEW ESM
- Bibliothèque spectrale SIMS statique disponible
- Réglage automatique de la lentille de l’optique ionique SIMS
- Alignement automatique des masses pour une performance optimale de l’ISSM
ToF-qSIMS Workstation : système SIMS quadrupolaire à temps de vol innovant
- Analyse SIMS statique sensible pour une spécificité de monocouche supérieure
- La gamme de masse élevée détecte les grosses molécules des polymères, des produits pharmaceutiques et de la médecine légale
- La haute résolution de masse sépare les interférences moléculaires
- La détection parallèle permet l’analyse a posteriori d’inconnus
- Imagerie hyperspectrale et profilage en profondeur pour une détermination rapide des distributions spatiales
- Profilage en profondeur à haute gamme dynamique et à sensibilité d’abondance
- Instrument SIMS entièrement flexible et à l’épreuve du temps
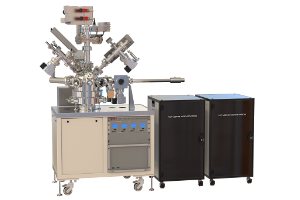

AutoSIMS : système automatique d'analyse de surface
- Analyse SIMS entièrement automatisée et sans surveillance
- Grande platine d’échantillonnage X-Y
- Canon à ions oxygène pour une analyse sensible
- Porte-échantillon personnalisable de type cassette
- Les paramètres peuvent être spécifiés via une feuille de calcul
- Caractérisation 3D
- Résolution en profondeur de l’ordre du nanomètre
- Service modulaire pour un temps de fonctionnement élevé
Compact SIMS : mesure la composition de surface des premiers nanomètres ou micromètres
- Système d’analyse UHV pour profilage de couches minces
- Gamme de masse : 50, 300, 510 ou 1000 amu
- Concentration minimale détectable : ppm
- SIMS – Spectrométrie de masse d’ions secondaires : oui
- Analyse des ions produits par la surface : oui (ions primaires d’oxygène ou argon)
- SNMS – Spectrométrie de masse d’ions secondaires : oui
- Analyse des ions produits par la surface : oui (ions primaires d’oxygène ou argon)
- Résolution en épaisseur : 3 nm
- Concentration minimale détectable – SIMS : 1017 atomes cm-3
- Concentration minimale détectable – SNMS : 1%
- Chambre UHV multiports : chambre à géométrie fixée facile d’accès
- Instruments supplémentaires : non


EQS SIMS : système pour l'analyse des ions secondaires positifs et négatifs d'échantillons solides
- Détecteur de comptage d’ions pulsés à haute sensibilité avec une gamme dynamique de 7 décades
- Contrôle de la trame pour un profilage et une imagerie en profondeur améliorés, avec déclenchement du signal intégré
- Analyseur de secteur électrostatique à 45°, balayage de l’énergie par incréments de 0,05 eV / 0,25 eV FWHM
- Perturbation minimale de la trajectoire des ions et transmission constante des ions à toutes les énergies
- Quadrupôle à triple filtre, options de masse jusqu’à 5000 amu
- Jauge de pénétrabilité et verrouillage pour assurer une protection contre les surpressions
- Option de pompage différentiel pour une utilisation dans des environnements à haute pression
- Commande MASsoft via RS232, RS485 ou Ethernet LAN
- Interface facile avec les systèmes existants
MAXIM : système pour les applications SIMS et SNMS statiques et dynamiques
- Options de gamme de masse : 300 amu, 500 amu ou 1000 amu
- Détecteur de comptage d’ions, détection des ions positifs et négatifs, 107 cps
- Filtre de masse : filtre triple
- Diamètre du pôle : 9 mm
- Cuisson au four : 250°C
- Filtre d’énergie ionique : acceptation angulaire de 30°
- Ioniseur : bombardement électronique, filament unique pour SNMS et RGA


IG5C : canon à ions césium de 5keV pour les applications d'analyse de surface UHV
- Source d’ions stable dans l’air
- Petite bride de montage pour une installation flexible
- Installation facile des sources de remplacement auto-alignées
- Longue durée de vie de la source
- Pompage différentiel pour maintenir la pression réelle de la chambre UHV
- Conception de colonne à deux lentilles
- Remplacement facile de l’ouverture définissant le faisceau
IG20 : source d'ions Argon ou Oxygène de 5keV pour les applications d'analyse de surface UHV
- Faisceau d’ions intense avec une taille de spot de 100 µm et des énergies de 0,5 – 5 keV
- Densité de courant élevée, jusqu’à 4,5 mA/cm²
- Source d’ions à impact électronique avec possibilité d’utiliser de l’argon et de l’oxygène
- Optique de guidage pour la diffusion de lignes et le tramage du faisceau dans le profilage en profondeur
- Décalage de 3° dans la colonne du canon à ions pour un rejet optimal des neutres
- Dispositif de suppression du faisceau pour une commutation rapide du faisceau dans les applications de tramage
- Pompage différentiel de la source pour réduire la charge en gaz de la chambre
- Ensemble à double filament facilement remplaçable
- Taux de balayage jusqu’à 64 µs
- Fonctionnement intégré avec les sondes SIM et EQS pour un contrôle direct de la vitesse de balayage et de la zone

